SMT migunakeun solder konvensional némpelkeun hawa reflow las analisa rongga jeung solusi (2023 Essence Edition), anjeun pantes eta!
1 Bubuka

Dina rakitan papan sirkuit, témpél solder dicitak dina pad solder papan sirkuit heula, teras sababaraha komponén éléktronik dipasang. Tungtungna, sanggeus tungku reflow, manik tin dina némpelkeun solder dilebur jeung sagala jinis komponén éléktronik jeung pad solder tina circuit board dilas babarengan pikeun ngawujudkeun assembly of submodules listrik. surfacemounttechnology (sMT) beuki loba dipaké dina produk bungkusan dénsitas luhur, kayaning pakét tingkat sistem (siP), alat ballgridarray (BGA), sarta Chip bulistir kakuatan, kotak datar pin-kirang pakét (quad aatNo-lead, disebut QFN). ) alat.
Alatan karakteristik prosés las témpél solder sareng bahan, saatos las reflow alat permukaan solder ageung ieu, bakal aya liang di daérah patri solder, anu bakal mangaruhan sipat listrik, sipat termal sareng sipat mékanis tina Performance produk, sareng malah ngakibatkeun kagagalan produk, kituna, pikeun ngaronjatkeun solder némpelkeun rongga las reflow geus jadi prosés jeung masalah teknis anu kudu direngsekeun, sababaraha peneliti geus dianalisis tur nalungtik nyababkeun BGA solder bola las rongga, jeung solusi perbaikan disadiakeun, némpelkeun solder konvensional reflow prosés las aréa las of QFN gede ti 10mm2 atawa aréa las gede ti 6 mm2 urang solusi chip bulistir kurang.
Anggo las Preformsolder sareng las tungku réfluks vakum pikeun ningkatkeun liang las. solder prefabricated merlukeun parabot husus pikeun titik fluks. Contona, chip ieu offset na tilted serius sanggeus chip disimpen langsung dina solder prefabricated. Lamun fluks Gunung chip nyaeta reflow lajeng nunjuk, prosés ngaronjat ku dua reflow, sarta biaya solder prefabricated sarta bahan fluks loba nu leuwih luhur ti némpelkeun solder.
Alat-alat vakum réfluks leuwih mahal, kapasitas vakum tina chamber vakum bebas pisan low, kinerja ongkos teu luhur, sarta masalah splashing tin serius, nu mangrupa faktor penting dina aplikasi tina dénsitas tinggi na pitch leutik. produk. Dina makalah ieu, dumasar kana prosés las reflow témpél solder konvensional, prosés las reflow sekundér anyar dikembangkeun sareng diwanohkeun pikeun ningkatkeun rongga las sareng ngarengsekeun masalah beungkeutan sareng retakan segel plastik disababkeun ku rongga las.
2 Solder némpelkeun percetakan reflow las rongga jeung mékanisme produksi
2.1 Rongga las
Saatos las reflow, produk diuji dina x-ray. Liang-liang dina zona las kalayan warna anu langkung hampang dipendakan kusabab solder anu teu cekap dina lapisan las, sapertos anu dipidangkeun dina Gambar 1.
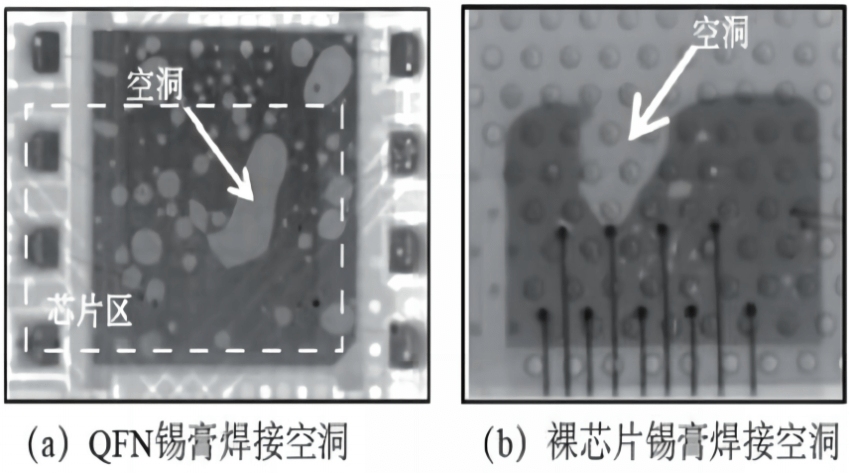
deteksi X-ray tina liang gelembung
2.2 Mékanisme formasi rongga las
Nyandak némpelkeun solder sAC305 sabagé conto, komposisi sareng fungsi utama dipidangkeun dina Tabel 1. Fluks sareng manik timah dihijikeun dina bentuk némpelkeun. Babandingan beurat solder timah ka fluks kira-kira 9:1, sareng rasio volume kira-kira 1:1.

Saatos némpelkeun solder dicitak sareng dipasang sareng sababaraha komponén éléktronik, némpelkeun solder bakal ngalaman opat tahapan preheating, aktivasina, réfluks sareng pendinginan nalika ngalangkungan tungku réfluks. Kaayaan némpelkeun solder ogé béda sareng suhu anu béda dina tahap anu béda, sapertos anu dipidangkeun dina Gambar 2.
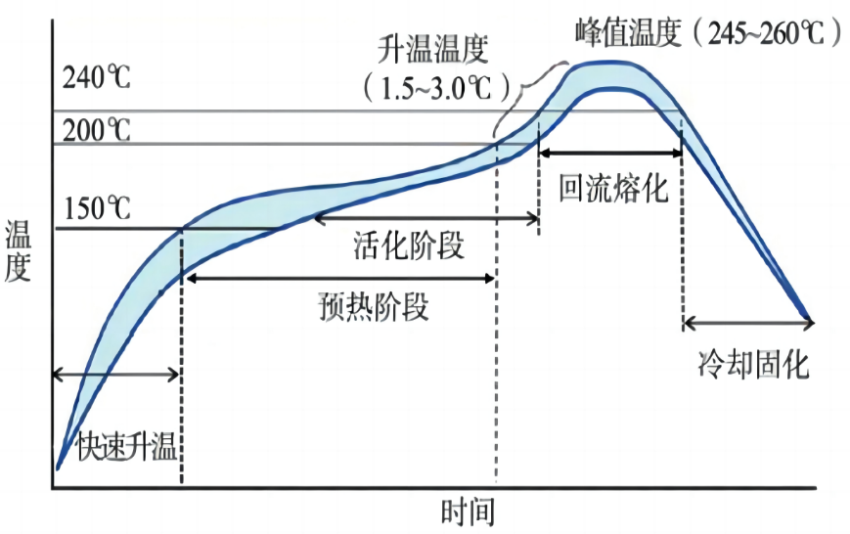
Rujukan profil pikeun tiap wewengkon reflow soldering
Dina tahap preheating jeung aktivasina, komponén volatile dina fluks dina némpelkeun solder bakal volatilized kana gas nalika dipanaskeun. Dina waktu nu sarua, gas bakal dihasilkeun nalika oksida dina beungeut lapisan las dihapus. Sababaraha gas ieu bakal volatilize sarta ninggalkeun némpelkeun solder, sarta manik solder bakal tightly condensed alatan volatilization of fluks. Dina tahap réfluks, fluks sésana dina némpelkeun solder bakal menguap gancang, manik tin bakal ngalembereh, jumlah leutik fluks gas volatile jeung lolobana hawa antara manik tin moal dispersed dina waktu, sarta residual dina tin molten na handapeun tegangan tina tin molten anu Hamburger sandwich struktur sarta bray ku circuit board solder Pad sareng komponenana éléktronik, sarta gas dibungkus dina tin cair hese kabur ngan ku buoyancy ka luhur Waktu lebur luhur pisan pondok. Nalika timah lebur niiskeun sareng janten timah padet, pori-pori muncul dina lapisan las sareng liang solder kabentuk, sapertos anu dipidangkeun dina Gambar 3.
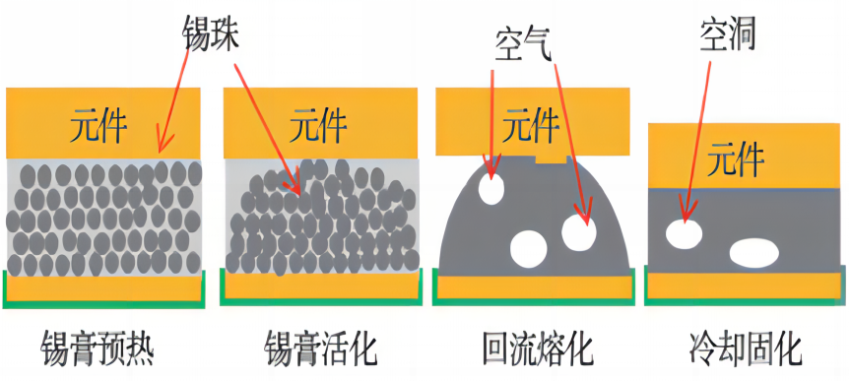
diagram Schematic of void dihasilkeun ku solder némpelkeun reflow las
Akar tina rongga las nyaéta hawa atawa gas volatile dibungkus dina némpelkeun solder sanggeus lebur teu lengkep discharged. Faktor anu mangaruhan kalebet bahan témpél solder, bentuk percetakan témpél solder, jumlah percetakan témpél solder, suhu réfluks, waktos réfluks, ukuran las, struktur sareng saterasna.
3. Verifikasi faktor influencing of solder némpelkeun percetakan reflow liang las
QFN jeung tés chip bulistir ieu dipaké pikeun mastikeun panyabab utama voids las reflow, sarta pikeun manggihan cara pikeun ngaronjatkeun voids las reflow dicitak ku némpelkeun solder. QFN jeung bulistir chip solder némpelkeun profil produk las reflow ditémbongkeun dina Gambar 4, QFN las ukuran permukaan 4.4mmx4.1mm, beungeut las ieu tinned lapisan (100% tin murni); Ukuran las tina chip bulistir nyaeta 3.0mmx2.3mm, lapisan las sputtered nikel-vanadium lapisan bimetallic, sarta lapisan permukaan nyaéta vanadium. Pad las substrat éta electroless nikel-palladium emas-dipping, sarta ketebalan éta 0.4μm / 0.06μm / 0.04μm. témpél solder SAC305 dianggo, alat percetakan témpél solder nyaéta DEK Horizon APix, alat tungku réfluks nyaéta BTUPyramax150N, sareng alat x-ray nyaéta DAGExD7500VR.
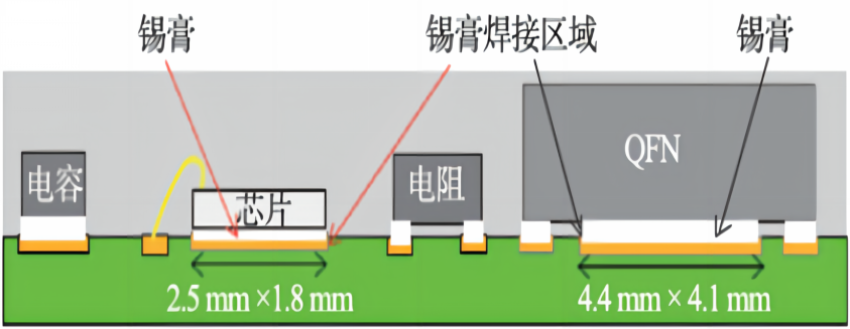
QFN sareng gambar las chip bulistir
Pikeun ngagampangkeun ngabandingkeun hasil tés, las reflow dilaksanakeun dina kaayaan dina Tabel 2.

Reflow las kaayaan tabel
Saatos ningkatna permukaan sareng las reflow réngsé, lapisan las dideteksi ku sinar-X, sareng kapanggih yén aya liang ageung dina lapisan las di handapeun QFN sareng chip bulistir, sapertos anu dipidangkeun dina Gambar 5.
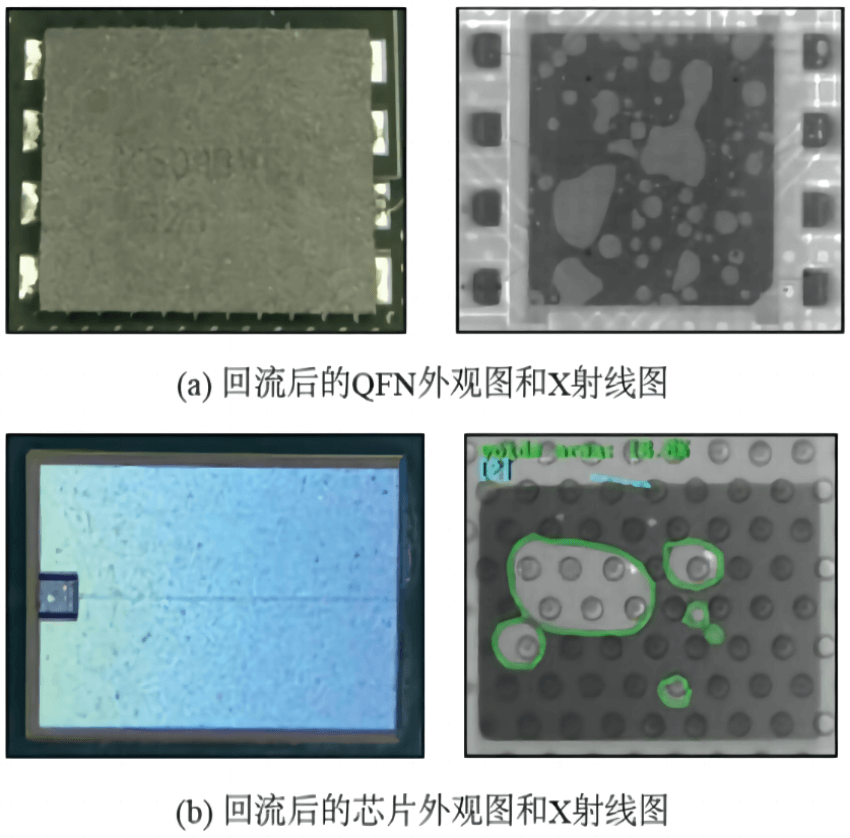
QFN sareng Chip Hologram (X-ray)
Kusabab ukuran tin bead, ketebalan bolong baja, laju aréa muka, bentukna bolong baja, waktos réfluks jeung suhu tungku puncak sadayana bakal mangaruhan voids reflow las, aya loba faktor influencing, nu bakal langsung diverifikasi ku test DOE, sarta jumlah ékspérimén. grup bakal badag teuing. Perlu gancang layar tur nangtukeun faktor pangaruh utama ngaliwatan test ngabandingkeun korelasi, lajeng salajengna ngaoptimalkeun faktor pangaruh utama ngaliwatan DOE.
3.1 Diménsi liang solder jeung solder némpelkeun manik tin
Kalayan type3 (ukuran manik 25-45 μm) tés témpél solder SAC305, kaayaan sanés tetep teu robih. Saatos reflow, liang dina lapisan solder diukur sareng dibandingkeun sareng némpelkeun solder type4. Kapanggih yén liang dina lapisan solder henteu béda sacara signifikan antara dua jinis némpelkeun solder, nunjukkeun yén némpelkeun solder kalayan ukuran manik anu béda-béda teu aya pangaruh anu jelas dina liang dina lapisan solder, anu sanés faktor anu mangaruhan. sakumaha ditémbongkeun dina Gbr. 6 Saperti ditémbongkeun.

Babandingan liang bubuk timah logam kalawan ukuran partikel béda
3.2 Ketebalan rongga las sareng bolong baja dicitak
Saatos reflow, wewengkon rongga tina lapisan dilas ieu diukur ku bolong baja dicitak jeung ketebalan tina 50 μm, 100 μm jeung 125 μm, jeung kaayaan séjén tetep unchanged. Ieu ieu kapanggih yén pangaruh ketebalan béda tina bolong baja (solder némpelkeun) on QFN ieu dibandingkeun jeung nu tina bolong baja dicitak jeung ketebalan tina 75 μm Salaku ketebalan tina bolong baja naek, aréa rongga laun nurun lalaunan. Sanggeus ngahontal ketebalan nu tangtu (100μm), wewengkon rongga bakal ngabalikeun tur mimitian ngaronjatkeun kalayan kanaékan ketebalan tina bolong baja, ditémbongkeun saperti dina Gambar 7.
Ieu nunjukeun yen nalika jumlah némpelkeun solder ngaronjat, timah cair jeung réfluks katutupan ku chip, sarta outlet kabur hawa residual ngan sempit dina opat sisi. Nalika jumlah némpelkeun solder dirobih, kaluaran hawa sésa-sésa ogé ningkat, sareng burst instan hawa anu dibungkus dina tin cair atanapi gas volatile anu lolos timah cair bakal nyababkeun tin cair nyembur di sekitar QFN sareng chip.
test kapanggih yén kalawan kanaékan ketebalan tina bolong baja, burst gelembung disababkeun ku ngewa hawa atawa gas volatile ogé bakal ningkat, sarta kamungkinan timah splashing sabudeureun QFN na chip ogé baris ngaronjatkeun correspondingly.

Babandingan liang dina bolong baja tina ketebalan béda
3.3 Babandingan aréa rongga las sareng pambukaan bolong baja
Bolong baja anu dicitak kalayan laju muka 100%, 90% sareng 80% diuji, sareng kaayaan sanésna tetep teu robih. Saatos reflow, wewengkon rongga tina lapisan dilas ieu diukur sarta dibandingkeun kalawan bolong baja dicitak kalawan laju muka 100%. Kapanggih yén henteu aya bédana anu signifikan dina rongga lapisan anu dilas dina kaayaan laju muka 100% sareng 90% 80%, sapertos anu dipidangkeun dina Gambar 8.

Babandingan rongga tina aréa pambukaan anu béda tina bolong baja anu béda
3.4 Rongga dilas sareng bentuk bolong baja dicitak
Jeung test bentuk percetakan tina némpelkeun solder of strip b jeung grid condong c, kaayaan séjén tetep unchanged. Saatos reflow, wewengkon rongga tina lapisan las diukur sarta dibandingkeun jeung bentuk percetakan tina grid a. Kapanggih yén henteu aya béda anu signifikan dina rongga lapisan las dina kaayaan grid, strip sareng grid condong, sapertos anu dipidangkeun dina Gambar 9.
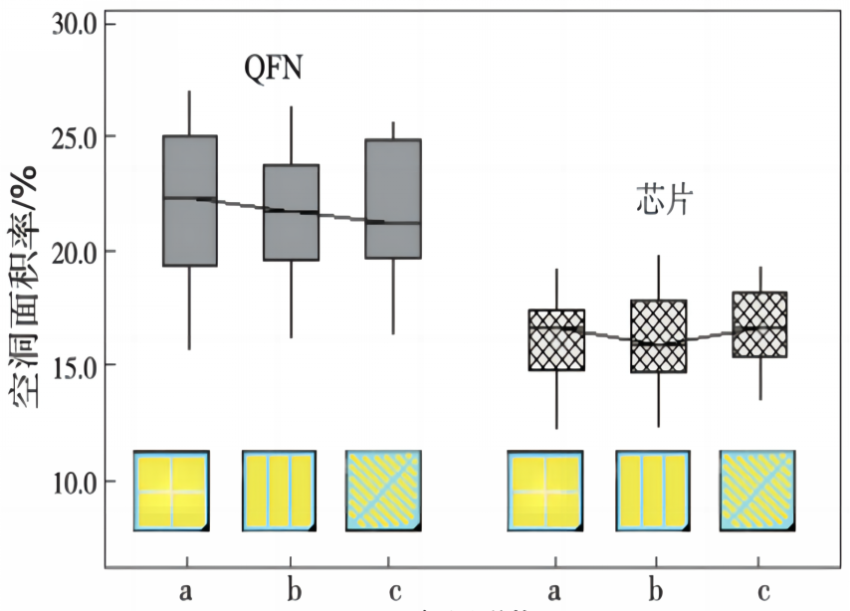
Babandingan liang dina modus bubuka béda tina bolong baja
3.5 Rongga las sareng waktos réfluks
Saatos waktos réfluks berkepanjangan (70 s, 80 s, 90 s) test, kaayaan séjén tetep unchanged, liang dina lapisan las diukur sanggeus réfluks, sarta dibandingkeun jeung waktu réfluks 60 s, ieu kapanggih yén kalawan kanaékan waktos réfluks, aréa liang las turun, tapi amplitudo réduksi laun turun kalawan kanaékan waktu, ditémbongkeun saperti dina Gambar 10. Ieu nunjukeun yen dina Dina kasus waktos réfluks cukup, ngaronjatna waktos réfluks anu kondusif pikeun mudal pinuh ku hawa dibungkus dina timah cair molten, tapi sanggeus waktu réfluks naek ka waktu nu tangtu, hawa dibungkus dina tin cair hese mudal deui. Waktu réfluks mangrupikeun salah sahiji faktor anu mangaruhan rohangan las.

Babandingan batal tina panjang waktos réfluks béda
3.6 Rongga las sareng suhu tungku puncak
Kalawan 240 ℃ jeung 250 ℃ test suhu tungku puncak jeung kaayaan séjén unchanged, wewengkon rongga tina lapisan dilas ieu diukur sanggeus reflow, sarta dibandingkeun jeung 260 ℃ suhu tungku puncak, ieu kapanggih yén dina kaayaan suhu tungku puncak beda, rongga tina lapisan dilas of QFN na chip teu robah nyata, ditémbongkeun saperti dina Gambar 11. Ieu nunjukeun yen puncak béda hawa tungku euweuh pangaruh atra on QFN jeung liang dina lapisan las tina chip, nu teu mangrupa faktor influencing.

Babandingan batal tina suhu puncak anu béda
Tés di luhur nunjukkeun yén faktor anu signifikan mangaruhan rongga lapisan weld QFN sareng chip nyaéta waktos réfluks sareng ketebalan bolong baja.
4 Solder némpelkeun percetakan reflow las pamutahiran rongga
4.1 Uji DOE pikeun ningkatkeun rongga las
Liang dina lapisan las of QFN na chip ieu ningkat ku manggihan nilai optimal faktor influencing utama (waktos réfluks jeung ketebalan bolong baja). Témpél solder nyaéta SAC305 type4, bentuk bolong baja mangrupikeun jinis grid (gelar bubuka 100%), suhu tungku puncak 260 ℃, sareng kaayaan uji anu sanés sami sareng alat uji. Uji DOE sareng hasil anu dipidangkeun dina Tabel 3. Pangaruh ketebalan bolong baja sareng waktos réfluks dina QFN sareng liang las chip anu dipidangkeun dina Gambar 12. Ngaliwatan analisis interaksi faktor pangaruh utama, Kapanggih yén ngagunakeun ketebalan bolong baja 100 μm. jeung 80 s waktos réfluks nyata bisa ngurangan rohangan las of QFN na chip. Laju rongga las tina QFN diréduksi tina maksimum 27,8% ka 16,1%, sarta laju rongga las tina chip diréduksi tina maksimum 20,5% ka 14,5%.
Dina tés, 1000 produk anu dihasilkeun dina kaayaan optimal (100 μm ketebalan baja bolong, 80 s waktos réfluks), sarta laju rongga las 100 QFN sarta chip ieu acak diukur. Laju rongga las rata-rata QFN éta 16,4%, sarta laju rongga las rata-rata chip éta 14,7% Laju rongga las tina chip sarta chip anu écés ngurangan.

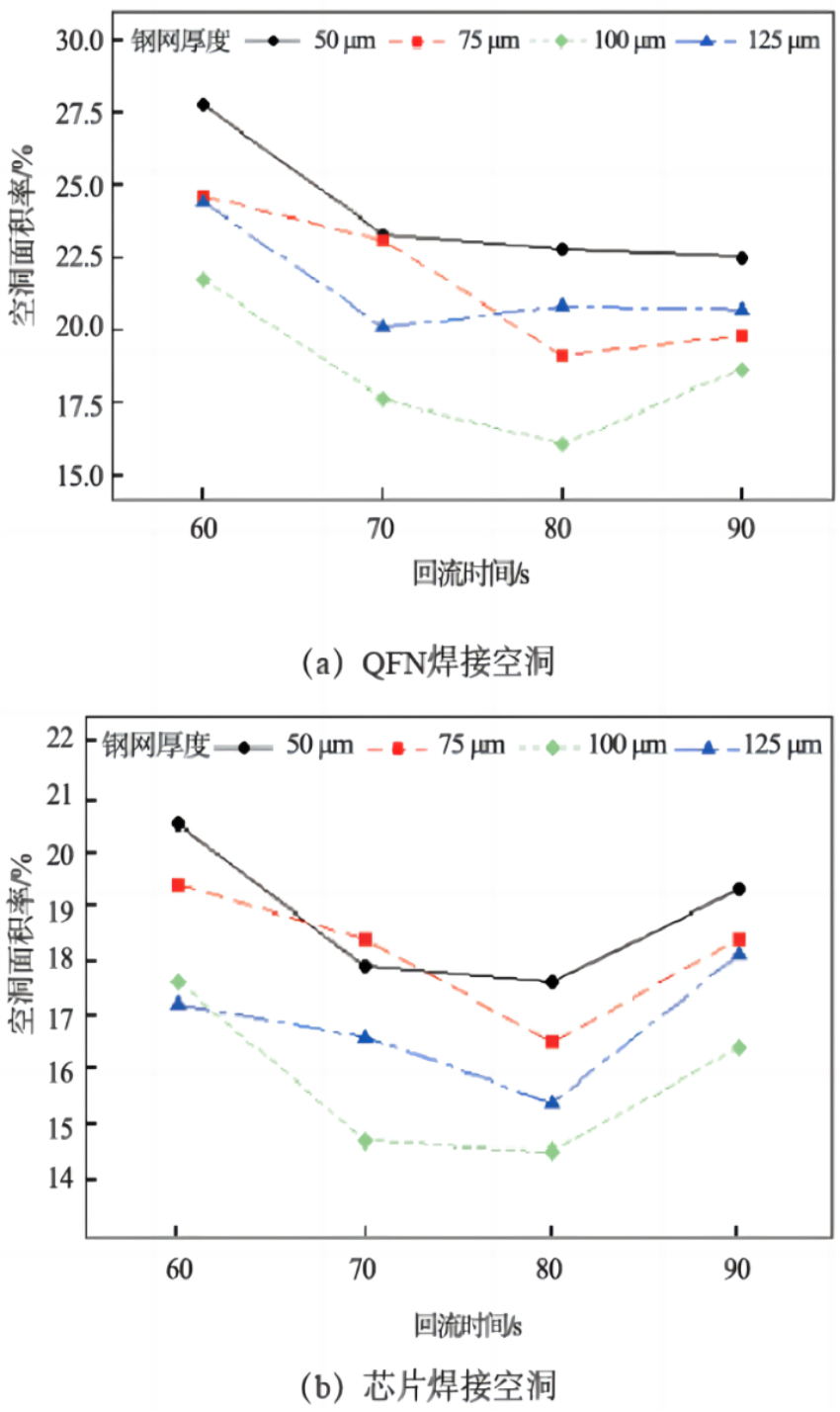
4.2 Prosés anyar ngaronjatkeun rongga las
Kaayaan produksi sabenerna sarta uji némbongkeun yén nalika aréa rongga las di handapeun chip kirang ti 10%, masalah retakan posisi rongga chip moal lumangsung salila beungkeutan kalungguhan jeung molding. Parameter prosés anu dioptimalkeun ku DOE henteu tiasa nyumponan sarat pikeun nganalisa sareng ngarengsekeun liang dina las reflow témpél solder konvensional, sareng laju aréa rongga las chip kedah dikirangan salajengna.
Kusabab chip katutupan dina solder nyegah gas dina solder ti escaping, laju liang di handapeun chip salajengna ngurangan ku ngaleungitkeun atawa ngurangan gas coated solder. A prosés anyar las reflow jeung dua percetakan némpelkeun solder diadopsi: hiji percetakan némpelkeun solder, hiji reflow teu nutupan QFN jeung chip bulistir discharging gas di solder; Prosés spésifik percetakan témpél solder sékundér, patch sareng réfluks sékundér dipidangkeun dina Gambar 13.
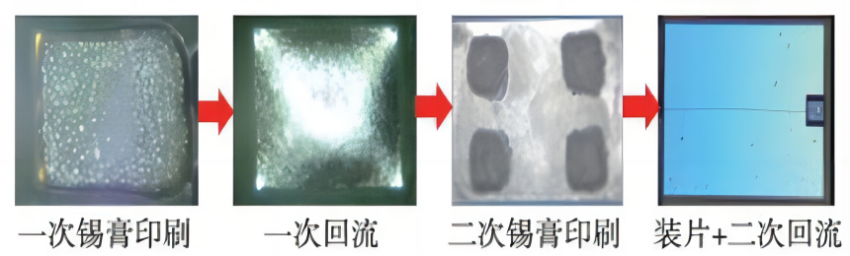
Nalika témpél solder kandel 75μm dicitak pikeun kahiji kalina, kalolobaan gas dina solder tanpa panutup chip kabur tina permukaan, sareng ketebalan saatos réfluks sakitar 50μm. Saatos réngsé réfluks primér, kuadrat leutik dicitak dina beungeut solder solidified tiis (dina raraga ngurangan jumlah némpelkeun solder, ngurangan jumlah spillover gas, ngurangan atawa ngaleungitkeun spatter solder), sarta némpelkeun solder kalawan. ketebalan 50 μm (hasil tés di luhur nunjukeun yen 100 μm téh pangalusna, jadi ketebalan tina percetakan sekundér nyaéta 100 μm.50 μm = 50 μm), lajeng install chip, lajeng balik ngaliwatan 80 s. Aya ampir euweuh liang dina solder sanggeus percetakan munggaran tur reflow, sarta némpelkeun solder dina percetakan kadua leutik, sarta liang las leutik, ditémbongkeun saperti dina Gambar 14.
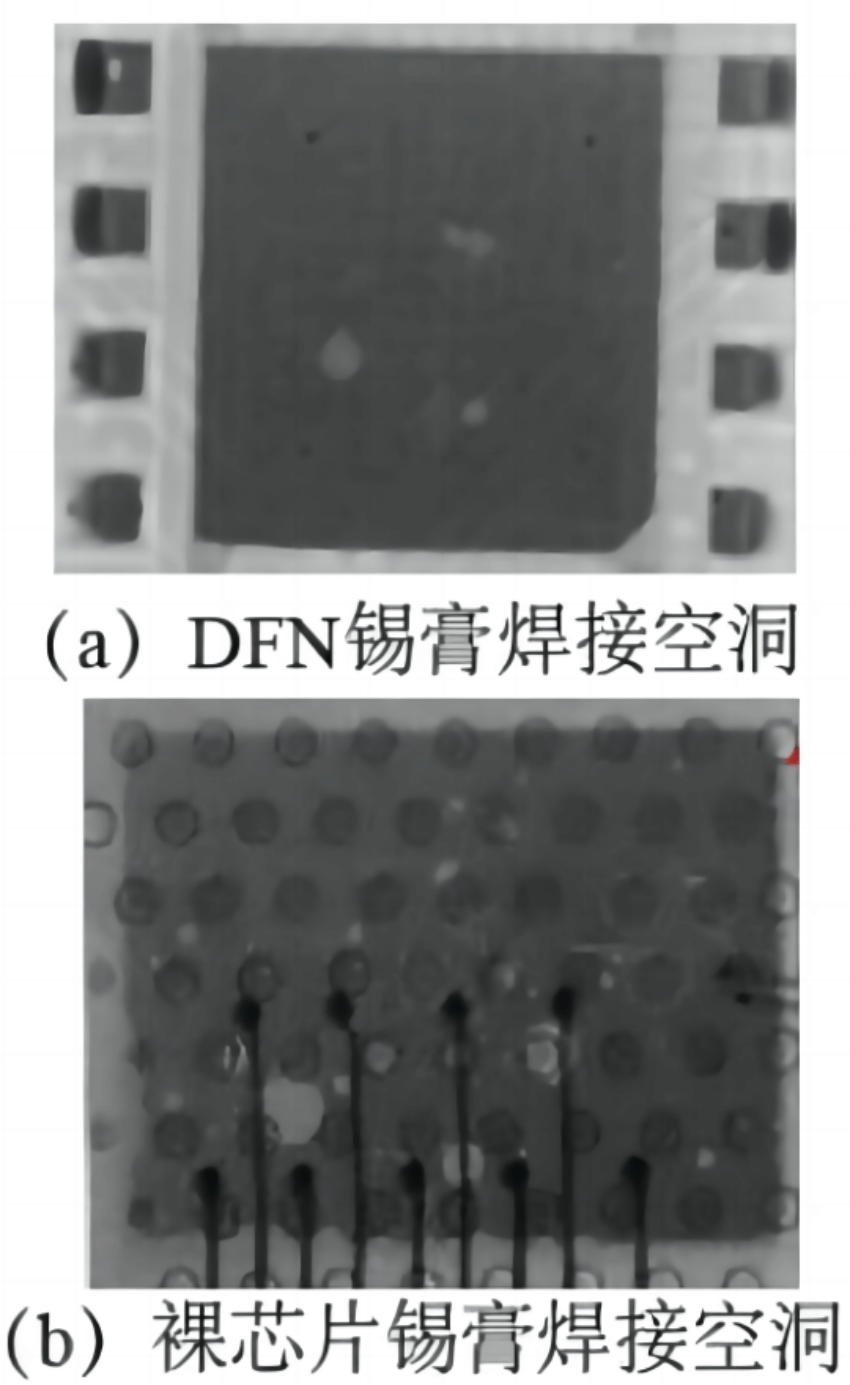
Saatos dua percetakan némpelkeun solder, gambar kerung
4.3 Verifikasi pangaruh rongga las
Produksi 2000 produk (ketebalan bolong baja percetakan kahiji nyaéta 75 μm, ketebalan bolong baja percetakan kadua nyaéta 50 μm), kaayaan sanésna teu robih, ukuran acak tina 500 QFN sareng laju rongga las chip, mendakan yén prosés énggal. sanggeus réfluks kahiji euweuh rongga, sanggeus réfluks kadua QFN Laju rongga las maksimum nyaéta 4,8%, sarta las maksimum laju rongga tina chip nyaéta 4,1%. Dibandingkeun jeung prosés las percetakan single-témpél aslina jeung prosés DOE dioptimalkeun, rongga las nyata ngurangan, ditémbongkeun saperti dina Gambar 15. Taya retakan chip kapanggih sanggeus tés fungsional sadaya produk.

5 Ringkesan
Optimasi jumlah percetakan némpelkeun solder sareng waktos réfluks tiasa ngirangan daérah rongga las, tapi tingkat rongga las masih ageung. Ngagunakeun dua solder némpelkeun percetakan téhnik las reflow bisa éféktif tur ngamaksimalkeun laju rongga las. Wewengkon las of QFN circuit bulistir chip tiasa 4.4mm x4.1mm na 3.0mm x2.3mm mungguh dina produksi masal Laju rongga tina las reflow dikawasa handap 5%, nu ngaronjatkeun kualitas sarta reliabilitas las reflow. Panalungtikan dina makalah ieu nyadiakeun rujukan penting pikeun ngaronjatkeun masalah rongga las permukaan las aréa badag.






